Skalbara HBT i GaAs och CMOS i GaN på Si för mm-vågor
Imec har demonstrerat komponenter av GaAs-baserade heterojunction bipolar transistor (HBT) på 300 mm Si och CMOS-kompatibla GaN- baserade enheter på 200 mm Si för mm-våg-applikationer. Resultaten hur både III-V-på-Si och GaN-på-Si som CMOS-kompatibel teknik kan möjliggöra RF-frontmoduler för millimetervågor.
Mobilbanden under 6 GHz är överbelastade. Därför har införandet av nya mm-våg-band en betydande inverkan på den totala 5G-nätinfrastrukturen och på mobila enheter. För mobila tjänster, och fast trådlös åtkomst (FWA), betyder det alltmer komplexa front-moduler som skickar signalen till och från antennen.
För att kunna arbeta vid mm-vågfrekvenser måste RF-frontmodulerna kunna överföra data snabbt (10 Gbit/s eller högre) med hög uteffekt. Dessutom ställer deras implementering i mobiltelefoner höga krav på deras formfaktor och effekteffektivitet. Utöver 5G kan dessa krav inte längre uppnås med dagens mest avancerade RF-frontmoduler som vanligtvis förlitar sig på en mängd olika tekniker. Bland annat används GaAs-baserade HBT för effektförstärkare som odlas på små och dyra GaAs-substrat.
– För att möjliggöra nästa generations RF-frontmoduler, utöver 5G, undersöker Imec CMOS-kompatibel III-V-on-Si-teknik, säger Nadine Collaert, programdirektör på imec.
Imec undersöker samintegration av front-end-komponenter (som effektförstärkare och omkopplare) med andra CMOS-baserade kretsar (som styrkretsar eller sändtagarteknologi), för att minska kostnads- och formfaktorn och möjliggöra nya hybridkretstopologier för att ta itu med prestanda och effektivitet.
Imec utforskar två olika rutter:
(1) Indiumfosfid (InP) på Si med en inriktning på mm-våg och frekvenser över 100 GHz (framtida 6G-applikationer).
(2) GaN-baserade enheter på Si med en inriktning (i en första fas) på lägre mm-vågband för applikationer där man har behov av hög effektdensitet.
– För båda vägarna har vi nu fått första funktionella enheter med lovande prestandaegenskaper och vi identifierade sätt att ytterligare förbättra deras driftsfrekvenser.
Funktionella GaAs / InGaP HBT-enheter odlade på 300 mm Si har visats som ett första steg mot att åstadkomma InP-baserade enheter. En defektfri stack, med under 3×106 cm-2 täthet, erhölls genom att använda Imecs unika III-V-process nano-ridge engineering (NRE). Komponenterna presterar avsevärt bättre än referenskomponenter av GaAs. De senare tillverkats på Si-substrat med ett buffertlager (SRB) som utjämnar spänningar till följd av skilda gitterkonstanter i materialen. I ett nästa steg kommer InP-baserade enheter med högre mobilitet (HBT och HEMT) att undersökas.
CMOS av GaN
Dessutom har CMOS-kompatibla GaN / AlGaN-baserade enheter på 200 mm Si tillverkats och jämför tre olika enhetsarkitekturer: HEMT, MOSFET och MISHEMT. Det visades att MISHEMT-enheter överträffar de andra enhetstyperna när det gäller komponentens skalbarhet och brusprestanda vid höga frekvenser. Cut-off-frekvenserna för fT / fmax runt 50/40 GHz erhölls för 300 nm grindlängder, vilket ligger i linje med rapporterade GaN-on-SiC-komponenter. Förutom ytterligare skalning av gate-längder visar de första resultaten att man med AlInN som ett spärrmaterial kan höja arbetsfrekvenserna till mm-vågbanden.
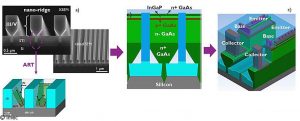
Fig 1. Beskrivning av NRE-metoden för hybrid III-V / CMOS-integration på 300 mm Si: (a) nano-dike där defekter fångas i det smala dikesområdet; (b) HBT-stacktillväxt med NRE och (c) olika layoutalternativ för HBT-enhetsintegration.
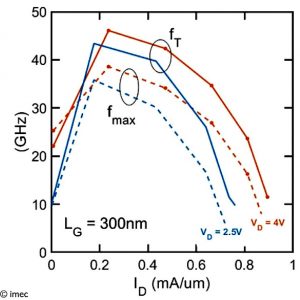
Fig 2. GaN / AlGaN-enheter på 200 mm Si: uppmätta avstängningsfrekvenser för strömförstärkningen (fT) och av den ensidiga effektförstärkningen (fmax).
Filed under: Halvledarteknik, Utländsk Teknik








